如何正确设定回流炉温度曲线
正确设定回流炉温度曲线是获得优良焊接质关键
前言
红外回流焊是SMT大生产中重要的工艺环节,它是一种自动群焊过程,成千上万个焊点在短短几分钟内一次完成,其焊接质量的优劣直接影响到产品的质量和可靠性,对于数字化的电子产品,产品的质量几乎就是焊接的质量。做好回流焊,人们都知道关键是设定回流炉的炉温曲线,有关回流炉的炉温曲线,许多专业文章中均有报导,但面对一台新的红外回流炉,如何尽快设定回流炉温度曲线呢?这就需要我们首先对所使用的锡膏中金属成分与熔点、活性温度等特性有一个全面了解,对回流炉的结构,包括加热温区的数量、热风系统、加热器的尺寸及其控温精度、加热区的有效长度、冷却区特点、传送系统等应有一个全面认识,以及对焊接对象--表面贴装组件(SMA)尺寸、组件大小及其分布做到心中有数,不难看出,回流焊是SMT工艺中复杂而又关键的一环,它涉及到材料、设备、热传导、焊接等方面的知识。
本文将从分析典型的焊接温度曲线入手,较为详细地介绍如何正确设定回流炉温度曲线,并实际介绍BGA以及双面回流焊的温度曲线的设定。
理想的温度曲线
图1是中温锡膏(Sn63/Sn62)理想的红外回流温度曲线,它反映了SMA通过回流炉时,PCB上某一点的温度随时间变化的曲线,它能直观反映出该点在整个焊接过程中的温度变化,为获得最佳焊接效果提供了科学的依据,从事SMT焊接的工程技术人员,应对理想的温度曲线有一个基本的认识,该曲线由四个区间组成,即预热区、保温区/活性区、回流区、冷却区,前三个阶段为加热区,最后一阶段为冷却区,大部分焊锡膏都能用这四个温区成功实现回流焊。故红外回流炉均设有4-5个温度,以适应焊接的需要。
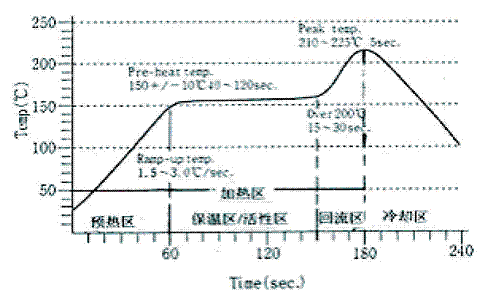
图1 理想的温度曲线
为了加深对理想的温度曲线的认识,现将各区的温度、停留时间以及焊锡膏在各区的变化情况,介绍如下:
(1) 预热区
预热区通常指由室温升至150℃左右的区域。在这个区域,SMA平稳升温,在预热区,焊膏中的部分溶剂能够及时挥发,元器件特别是IC器件缓缓升温,以适应以后的高温。但SMA表面由于元器件大小不一,其温度有不均匀现象,在预热区升温的速率通常控制在1.5℃-3℃/sec。若升温太快,由于热应力的作用,导致陶瓷电容的细微裂纹、PCB变形、IC芯片损坏,同时锡膏中溶剂挥发太快,导致飞珠的发生。炉子的预热区一般占加热信道长度的1/4-1/3,其停留时间计算如下:设环境温度为25℃,若升温速率按3℃/sec计算则(150-25)/3即为42sec,若升温速率按1.5℃/sec计算则(150-25)/ 1.5即为85sec。通常根据组件大小差异程度调整时间以调控升温速率在2℃/sec以下为最佳。
(2) 保温区/活性区
保温区又称活性区,在保温区温度通常维持在150℃±10℃的区域,此时锡膏处于熔化前夕,焊膏中的挥发物进一步被去除,活化剂开始激活,并有效地去除焊接表面的氧化物,SMA表面温度受热风对流的影响,不同大小、不同质地的元器件温度能保持均匀,板面温度差△T接近最小值,曲线形态接近水平状,它也是评估回流炉工艺性的一个窗口,选择能维持平坦活性温度曲线的炉子将提高SMA的焊接效果,特别是防止立碑缺陷的产生。通常保温区在炉子的二、三区之间,维持时间约60-120s,若时间过长也会导致锡膏氧化问题,以致焊接后飞珠增多。
(3) 回流区
回流区的温度最高,SMA进入该区后迅速升温,并超出锡膏熔点约30℃-40℃,即板面温度瞬时达到215℃-225℃(此温度又称之为峰值温度),时间约为5-10sec,在回流区焊膏很快熔化,并迅速润湿焊盘,随着温度的进一步提高,焊料表面张力降低,焊料爬至组件引脚的一定高度,形成一个"弯月面"。从微观上看,此时焊料中的锡与焊盘中的铜或金由于扩散作用而形成金属间化合物,以锡铜合金为例,当锡膏熔化后,并迅速润湿铜层,锡原子与铜原子在其界面上互相渗透初期Sn-Cu合金的结构为 Cu6Sn5,其厚度为1-3μ,若时间过长、温度过高时,Cu原子进一步渗透到Cu6Sn5中,其局部组织将由Cu6Sn5转变为Cu3Sn合金,前者合金焊接强度高,导电性能好,而后者则呈脆性,焊接强度低、导电性能差,SMA在回流区停留时间过长或温度超高会造成PCB板面发黄、起泡、以致元器件损坏。SMA在理想的温度下回流,PCB色质保持原貌,焊点光亮。在回流区,锡膏熔化后产生的表面张力能适度校准由贴片过程中引起的元器件引脚偏移,但也会由于焊盘设计不正确引起多种焊接缺陷,如"立碑"、"桥联"等。回流区的升温速率控制在2.5-3℃/sec,一般应在25sec-30sec内达到峰值温度。
(4) 冷却区
SMA运行到冷却区后,焊点迅速降温,焊料凝固。焊点迅速冷却可使焊料晶格细化,结合强度提高,焊点光亮,表面连续呈弯月面状。通常冷却的方法是在回流炉出口处安装风扇,强行冷却。新型的回流炉则设有冷却区,并采用水冷或风冷。理想的冷却曲线同回流区升温曲线呈镜面对称分布。
在大生产中,每个产品的实际工作曲线,应根据SMA大小、组件的多少及品种反复调节才能获得,从时间上看,整个回流时间为175sec-295sec即3分钟-5分钟左右,(不包括进入第一温区前的时间)。
温度曲线的设定
1、 测试工具:
在开始测定温度曲线之前,需要有温度测试仪,以及与之相配合的热电偶,高温焊锡丝、高温胶带以及待测的SMA,当然有的回流炉自身带有温度测试仪,(设在炉体内),但因附带的热电偶较长,使用不方便,不如专用温度测试记录仪方便。特别这类测试仪所用的小直径热电偶,热量小、响应快、得到的结果精确。
2、 热电偶的位置与固定
热电偶的焊接位置也是一个应认真考虑的问题,其原则是对热容量大的组件焊盘处别忘了放置热电偶,见图2,此外对热敏感组件的外壳,PCB上空档处也应放置
热电偶,以观察板面温度分布状况。
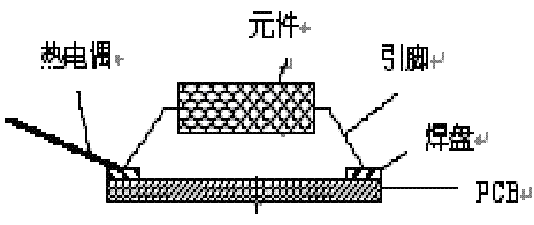
图2 热电偶的位置
将热电偶固定在PCB上最好的方法是采用高温焊料(Sn96Ag4)焊接在所需测量温度的地方,此外还可用高温胶带固定,但效果没有直接焊接的效果好。总之根据SMA大小以及复杂减度设有3个或更多的电偶。电偶数量越多,其对了解SMA板面的受热情况越全面。
3、锡膏性能
对于所使用锡膏的性能参数也是必须考虑的因素之一,首先是考虑到其合金的熔点,即回流区温度应高于合金熔点的30-40℃。其次应考虑锡膏的活性温度以及持续的时间,有条件时应与锡膏供应商了解,也可以参考供应商提供的温度曲线。
4.炉子的结构:
对于首次使用的回流炉,应首先考察一下炉子的结构。看一看有几个温区,有几块发热体,是否独立控温。热电偶放置在何处。热风的形成与特点,是否构成温区内循环,风速是否可调节。每个加热区的长度以及加热温区的总长度。目前使用的红外回流炉,一般有四个温区,每个加热区有上下独立发热体。热风循环系统各不相同,但基本上能保持各温区独立循环。通常第一温区为预热区,第二、三温区为保温区,第四温区为回流区,冷却温区为炉外强制冷风,近几年来也出现将冷却区设在炉内,并采用水冷却系统。当然这类炉子其温区相应增多,以至出现八温区以上的回流炉。随着温区的增多,其温度曲线的轮廓与炉子的温度设置将更加接近,这将会方便于炉温的调节。但随着炉子温区增多,在生产能力增加的同时其能耗增大、费用增多。
5、炉子的带速:
设定温度曲线的第一个考虑的参数是传输带的速度设定,故应首先测量炉子的加热区总长度,再根据所加工的SMA尺寸大小、元器件多少以及元器件大小或热容量的大小决定SMA在加热区所运行的时间。正如前节所说,理想炉温曲线所需的焊接时间约为3-5分钟,因此不难看出有了加热区的长度,以及所需时间,就可以方便地计算出回流炉运行速度。
各区温度设定:
接下来必须设定各个区的温度,通常回流炉仪表显示的温度仅代表各加热器内热电偶所处位置的温度,并不等于SMA经过该温区时其板面上的温度。如果热电偶越靠近加热源,显示温度会明显高于相应的区间温度,热电偶越靠近PCB的运行信道,显示温度将越能反应区间温度,因此可打开回流炉上盖了解热电偶所设定的位置。当然也可以用一块试验板进行模拟测验,找出PCB上温度与表温设定的关系,通过几次反复试验,最终可以找出规律。当速度与温度确定后,再适当调节其它参数如冷却风扇速度,强制空气或N2流量,并可以正式使用所加工的SMA进行测试,并根据实测的结果与理论温度曲线相比较或与锡膏供应商提供的曲线相比较。并结合环境温度、回流峰值温度、焊接效果、以及生产能力适当的协调。最后将炉子的参数记录或储存以备后用。虽然这个过程开始较慢和费力,但最终可以以此为依据取得熟练设定炉温曲线的能力。
两种典型的温度曲线设定
1、 BGA焊接温度的设定
BGA是近几年使用较多的封装器件,由于它的引脚均处于封装体的下方,因为焊点间距较大(1.27mm)焊接后不易出现桥连缺陷,但也带来一些新问题,即焊点易出现空洞或气泡,而在QFP或PLCC器件的焊接中,这类缺陷相对的要少得多。就其原因来说这与BGA焊点在其下方阴影效应大有关。故会出现实际焊接温度比其它元器件焊接温度要低的现状,此时锡膏中溶剂得不到有效的挥发,包裹在焊料中。图3为实际测量到的BGA器件焊接温度。图中,第一根温度曲线为BGA外侧,第二根温度曲线为BGA焊盘上,它是通过在PCB上开一小槽,并将热电偶伸入其中,两温度上升为同步上升,但第二根温度曲线显示出的温度要低8℃左右,这是BGA体积较大,其热容量也较大的缘故,故反映出组件体内的温度要低,这就告诉我们,尽管热电偶放在BGA体的外侧仍不能如实地反映出BGA焊点处的温度。因此实际工作中应尽可能地将热电偶伸入到BGA体下方,并调节BGA的焊接温度使它与其它组件温度相兼容。

图3 BGA温度测试点的选择
2、 双面板焊接温度的设定
早期对双面板回流焊接时,通常要求设计人员将器件放在PCB的一侧,而将阻容组件放在另一侧,其目的是防止第二面焊接时组件在二次高温时会脱落。但随着布线密度的增大或SMA功能的增多,PCB双面布有器件的产品越来越多,这就要求我们在调节炉温曲线时,不仅在焊接面设定热电偶而且在反面也应设定热电偶,并做到在焊接面的温度曲线符合要求的同时,SMA反面的温度最高值不应超过锡膏熔化温度(179℃),见图4

图4 双面板焊接温度曲线
从图中看出当焊接面的温度达到215℃时反面最高温度仅为165℃,未达到焊膏熔化温度。此时SMA反面即使有大的元器件,也不会出现脱落现象。
常见有缺陷的温度曲线
下列温度曲线是设定时常见的缺陷:
1、活性区温度梯度过大
立碑是片式组件常见的焊接缺陷,引起的原因是由于组件焊盘上的锡膏熔化时润湿力不平衡,导致组件两端的力距不平衡故易引起组件立碑。引起立碑的原因有多方面,其中两焊盘上的温度不一致是其原因之一。图5所示的温度曲线表明活性区温度梯度过大,这意味着PCB板面温度差过大,特别是靠近大器件四周的阻容组件两端温度受热不平衡,锡膏熔化时间有一个延迟故易引起立碑缺陷。解决的方法是调整活性区的温度。
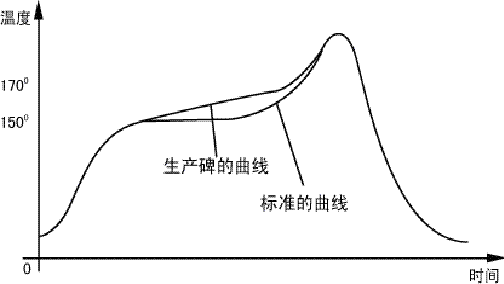
图5 活性区温度梯度过大
2、活性区温度过低
图6所示的温度曲线表明,活性区温度过低,此时易引起锡膏中溶剂得不到充分挥发,当到回流区时锡膏中溶剂受高温易引起激烈挥发,其结果会导致飞珠的形成。

图6 活性区温度过低
3、回流区温度过高或过低
图7中曲线1所示的温度曲线表明回流温度过高,易造成PCB以及元器件损伤,应降低回流区温度,而曲线2所示的温度表明回流温度过低。此时焊料虽已熔化,但流动性差。焊料不能充分润湿,故易引起虚焊或冷焊。
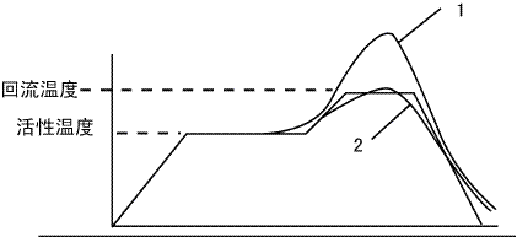
图7 回流区温度不正确
4、热电偶出故障
图8所示温度曲线,曲线出现明显抖动,曲线如锯齿状,这通常是由于用来测试温度的热电偶出现故障。

图8 热电偶出故障
综上所述,面对首次使用的回流炉,当测试温度曲线时,应对回流炉的结构、锡膏性能、SMA的大小及元器件的分布等全面了解。首先设定带速,然后调节温度,并与理想温度曲线比较,反复调节,就能得到实际产品所需要的温度曲线和满意的焊接效果。
以上资料仅供参考,不作其它用途。

